參考價(jià)格
面議型號
PHI Quantes品牌
高德英特產(chǎn)地
北京樣本
暫無誤差率:
*分辨率:
*重現(xiàn)性:
*儀器原理:
其他分散方式:
*測量時(shí)間:
*測量范圍:
*看了PHI Quantes 雙掃描XPS探針的用戶又看了
 留言詢價(jià)
留言詢價(jià)

虛擬號將在 180 秒后失效
使用微信掃碼撥號
PHI Quantes 雙掃描XPS探針
簡介
PHI Quantes
雙掃描XPS探針是以Quantera II系統(tǒng)為基礎(chǔ),進(jìn)行技術(shù)升級后得到的全新版本,。PHI
Quantes的主要突出特點(diǎn),,是擁有世界**的同焦Al Ka和Cr Ka的雙掃描X射線源;相比常規(guī)的Al Ka X射線源,,能量高達(dá)5.4
KeV的Cr
Ka作為硬X射線源,,一方面可以探測到表面更深度的信息,另一方面還可得到更寬能量范圍的能譜信息,,使光電子能譜數(shù)據(jù)資訊達(dá)到更內(nèi)部,、更深層和更寛能量的結(jié)果。Quantes是一套技術(shù)成熟的高性能XPS系統(tǒng),,在未來表面科學(xué)研究中將發(fā)揮至關(guān)重要的作用。

優(yōu)勢
樣品表面更深的深度信息
Cr Ka和Al Ka激發(fā)的光電子具有不同的非彈性平均自由程,,因此可以探測到不同的深度信息,,一般的預(yù)期是Cr Ka數(shù)據(jù)中深度訊息會比Al Ka深三倍,使Quantes的分析能力得到重大的提升,。
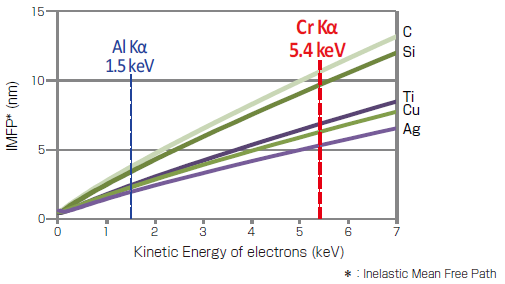
如上圖可見Cr Ka的非彈性自由層的深度是Al Ka的三倍,。
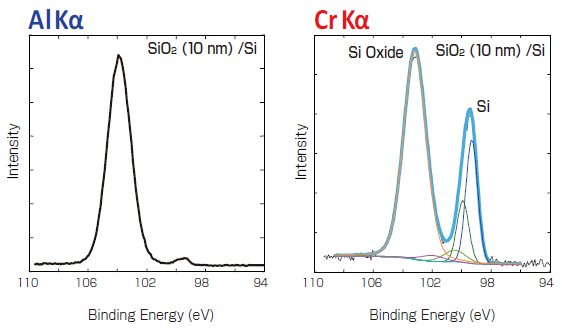
如上圖左,使用Al Ka測試一SiO2 10nm厚樣式基本只看到表面的氧化硅,;而在右圖所示在使用Cr Ka分析同一樣品可同時(shí)偵測出表面氧化硅和深度10nm后更深金屬硅的訊號,。
探測高結(jié)合能的內(nèi)層電子和更寛的XPS能譜
當(dāng)內(nèi)層電子的結(jié)合能高于1.5 KeV而小于5.4 KeV時(shí),該層電子無法被Al Ka X射線激發(fā)產(chǎn)生光電子,,但是卻能被Cr Ka X射線激發(fā)產(chǎn)生光電子,。因此,使用Cr Ka能夠在激發(fā)更內(nèi)層光電子的同時(shí)得到能量范圍更寬的光電子能譜(如下圖),。

特點(diǎn)

PHI Quantes設(shè)備雙單色光源的示意圖
雙單色化的X射線源,,Cr Ka(4 KeV)和Al Ka(1.5 KeV)
Cr Ka分析深度是Al Ka的三倍

如上圖,PHI Quantes雙光源都可掃描聚焦的同時(shí)定位可保證為完全一致
Cr Ka與Al Ka雙X射線源能夠?qū)崿F(xiàn)同點(diǎn)分析
技術(shù)成熟的雙束電荷中和技術(shù)
Cr Ka 定量靈敏因子
可選配件
樣品定位系統(tǒng)(SPS)
樣品處理室(Preparation chamber)
冷/熱變溫樣品臺
團(tuán)簇離子源 GCIB
應(yīng)用實(shí)例分析
例一:金屬氧化物Fe-Cr合金分析
光電子能譜圖中,,有時(shí)會出現(xiàn)X光激發(fā)產(chǎn)生的光電子與某些俄歇電子能量范圍重合的情況,。例如在探測Fe-Cr合金全譜時(shí),PHI Quantes可以一鍵切換Cr Ka與Al Ka X射線源,,那么光電子與俄歇電子就能夠在全譜中很好的區(qū)分開(如下圖),。
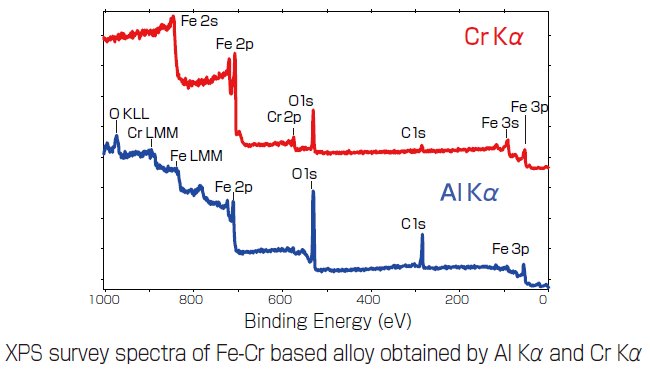
如下圖,盡管在Fe2p和Cr2p的精細(xì)譜中,,Al Ka得到的Fe2p與俄歇電子譜峰稍有重疊,,但是根據(jù)不同的深度信息,我們依然可以發(fā)現(xiàn)Fe和Cr的氧化物只存在于樣品的表面,。詳細(xì)研究Fe和Cr之間的氧化物含量可能導(dǎo)致氧化物厚度或深度的差異,。
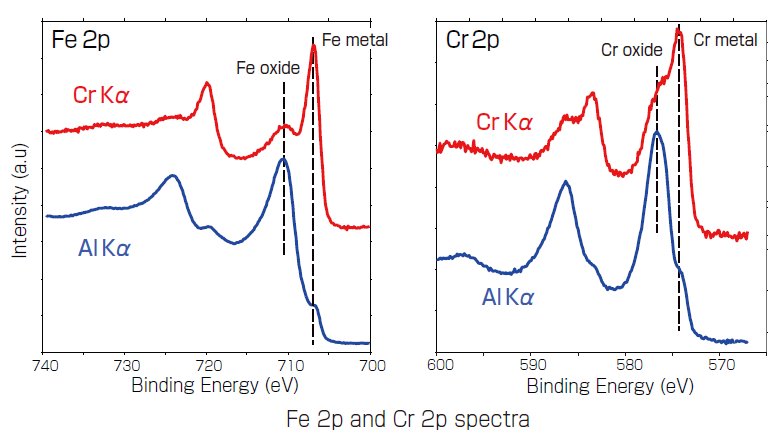
例二: 褪色的銅電極分析
如下圖中光學(xué)顯微鏡下,,可以觀察到銅電極產(chǎn)品上顏色發(fā)生了變化,以此定位分析點(diǎn)A/B和a/b,。再使用 PHI Quantes 對樣品這買個(gè)區(qū)域做分析,。
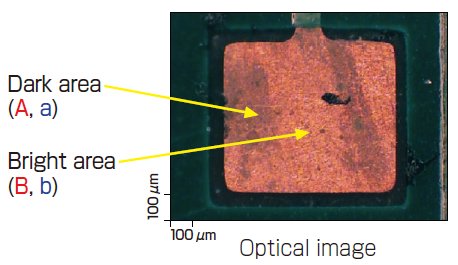
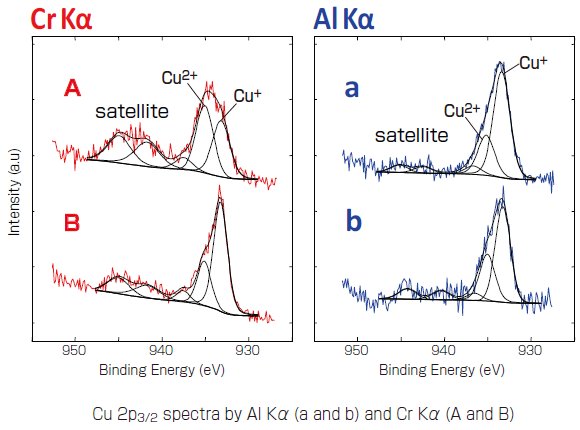
使用PHI Quantes分析此樣品得到上圖的結(jié)果,當(dāng)中 Cr Ka在(A,B)兩個(gè)分析區(qū)域結(jié)果Cu2+和Cu+組成比例有明顯的不同,。但是在使用Al Ka分析(a,b)兩區(qū)域時(shí),,Cu2+和Cu+化學(xué)態(tài)和組成比基本沒有明顯的差別。
這個(gè)結(jié)果表明:在亮暗區(qū)域,,Cu主要以Cu2O形式存在,。但是,用Cr Ka探測到暗處有更多的CuO,,說明CuO更多的存在于Cu2O的下面,。
例三: 多層薄膜分析
如下圖,對一多層薄膜使用PHI Quantes分析,,留意圖中所標(biāo)示在不同X射線源(Al Ka & Cr Ka)和不同樣品測試傾角時(shí),,使用了藍(lán)/綠/紅示意出XPS分析深度的不同。
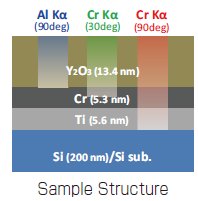
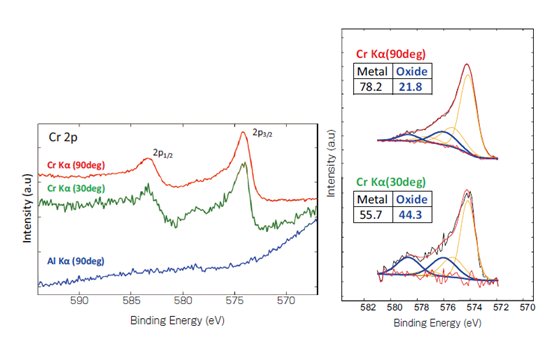
如以左上圖藍(lán)/綠/紅圖譜結(jié)果中可見,,只有通過PHI Quantes Cr Ka分析才可以直接透過XPS探測到14nm的Y2O3層下面的Cr層Cr2p信息,。而右上圖曲線擬合結(jié)果也可以用來研究Cr的化學(xué)狀態(tài)。通過研究Cr Ka 在90°和30°入射得到的譜圖可知,,Cr氧化物是存在在Y2O3和Cr之間的界面,。
暫無數(shù)據(jù)!
 PHI Quantes 雙掃描XPS探針的工作原理介紹?
PHI Quantes 雙掃描XPS探針的工作原理介紹? PHI Quantes 雙掃描XPS探針的使用方法,?
PHI Quantes 雙掃描XPS探針的使用方法,? PHI Quantes 雙掃描XPS探針多少錢一臺,?
PHI Quantes 雙掃描XPS探針多少錢一臺,? PHI Quantes 雙掃描XPS探針使用的注意事項(xiàng)
PHI Quantes 雙掃描XPS探針使用的注意事項(xiàng) PHI Quantes 雙掃描XPS探針的說明書有嗎?
PHI Quantes 雙掃描XPS探針的說明書有嗎? PHI Quantes 雙掃描XPS探針的操作規(guī)程有嗎,?
PHI Quantes 雙掃描XPS探針的操作規(guī)程有嗎,? PHI Quantes 雙掃描XPS探針的報(bào)價(jià)含票含運(yùn)費(fèi)嗎,?
PHI Quantes 雙掃描XPS探針的報(bào)價(jià)含票含運(yùn)費(fèi)嗎,? PHI Quantes 雙掃描XPS探針有現(xiàn)貨嗎?
PHI Quantes 雙掃描XPS探針有現(xiàn)貨嗎? PHI Quantes 雙掃描XPS探針包安裝嗎,?
PHI Quantes 雙掃描XPS探針包安裝嗎,? 手機(jī)版:
手機(jī)版:




