
復納科學儀器(上海)有限公司
 金牌會員
金牌會員 已認證
已認證

復納科學儀器(上海)有限公司
 金牌會員
金牌會員 已認證
已認證
電子顯微鏡已經(jīng)成為表征各種材料的有力工具,。 它的多功能性和極高的空間分辨率使其成為許多應用中非常有價值的工具,。 其中,兩種主要的電子顯微鏡是透射電子顯微鏡(TEM)和掃描電子顯微鏡(SEM),。 在這篇博客中,,將簡要描述他們的相似點和不同點。
從相似點開始, 這兩種設備都使用電子來獲取樣品的圖像,。 他們的主要組成部分是相同的;
電子源
電磁和靜電透鏡控制電子束的形狀和軌跡
光闌
所有這些組件都存在于高真空中,。
現(xiàn)在轉向這兩種設備的差異性。 掃描電鏡(SEM)使用一組特定的線圈以光柵樣式掃描樣品并收集散射的電子,。
而透射電鏡(TEM)是使用透射電子,,收集透過樣品的電子。 因此,,透射電鏡(TEM)提供了樣品的內(nèi)部結構,,如晶體結構,形態(tài)和應力狀態(tài)信息,而掃描電鏡(SEM)則提供了樣品表面及其組成的信息,。
而且,,這兩種設備最明顯的差別之一是它們可以達到的最佳空間分辨率; 掃描電鏡(SEM)的分辨率被限制在 ?0.5nm,而隨著最近在球差校正透射電鏡(TEM)中的發(fā)展,,已經(jīng)報道了其空間分辨率甚至小于 50pm,。
哪種電子顯微鏡技術最適合操作員進行分析?
這完全取決于操作員想要執(zhí)行的分析類型,。 例如,,如果操作員想獲取樣品的表面信息,如粗糙度或污染物檢測,,則應選擇掃描電鏡(SEM),。 另一方面,如果操作員想知道樣品的晶體結構是什么,,或者想尋找可能存在的結構缺陷或雜質(zhì),,那么使用透射電鏡(TEM)是唯一的方法。
掃描電鏡(SEM)提供樣品表面的 3D 圖像,,而透射電鏡(TEM)圖像是樣品的 2D 投影,,這在某些情況下使操作員對結果的解釋更加困難。
由于透射電子的要求,,透射電鏡(TEM)的樣品必須非常薄,,通常低于 150nm,并且在需要高分辨率成像的情況下,,甚至需要低于 30nm,,而對于掃描電鏡(SEM)成像,沒有這樣的特定要求,。
這揭示了這兩種設備之間的另一個主要差別:樣品制備,。掃描電鏡( SEM)的樣品很少需要或不需要進行樣品制備,并且可以通過將它們安裝在樣品杯上直接成像,。
相比之下,,透射電鏡(TEM)的樣品制備是一個相當復雜和繁瑣的過程,只有經(jīng)過培訓和有經(jīng)驗的用戶才能成功完成,。 樣品需要非常薄,,盡可能平坦,并且制備技術不應對樣品產(chǎn)生任何偽像(例如沉淀或非晶化 ),。 目前已經(jīng)開發(fā)了許多方法,,包括電拋光,機械拋光和聚焦離子束刻蝕,。 專用格柵和支架用于安裝透射電鏡(TEM)樣品,。
這兩種電子顯微鏡系統(tǒng)在操作方式上也有所不同,。 掃描電鏡(SEM)通常使用 15kV 以上的加速電壓,而透射電鏡(TEM)可以將其設置在 60-300kV 的范圍內(nèi),。
與掃描電鏡(SEM)相比,,透射電鏡(TEM)提供的放大倍數(shù)也相當高:透射電鏡(TEM)可以將樣品放大5000萬倍以上,而對于掃描電鏡(SEM)來說,,限制在 1-2 百萬倍之間,。
然而,掃描電鏡(SEM)可以實現(xiàn)的最大視場(FOV)遠大于透射電鏡(TEM),,用戶可以只對樣品的一小部分進行成像,。 同樣,掃描電鏡(SEM)系統(tǒng)的景深也遠高于透射電鏡(TEM)系統(tǒng),。

圖1:硅的電子顯微鏡圖像。 a)使用掃描電鏡 SEM 成像的二次電子圖像,,提供關于表面形態(tài)的信息,,而 b)透射電鏡(TEM)圖像顯示關于樣品內(nèi)部的結構信息。
另外,,在兩個系統(tǒng)中創(chuàng)建圖像的方式也是不同的,。 在掃描電鏡中,樣品位于電子光學系統(tǒng)的底部,,散射電子(背散射或二次)被電子探測器捕獲,, 然后使用光電倍增管將該信號轉換成電信號,該電信號被放大并在屏幕上產(chǎn)生圖像,。
在透射電鏡(TEM)中,,樣品位于電子光學系統(tǒng)的中部。 入射電子穿過它,,并通過樣品下方的透鏡(中間透鏡和投影透鏡),,圖像直接顯示在熒光屏上或通過電荷耦合器件(CCD)相機顯示在 PC 屏幕上。
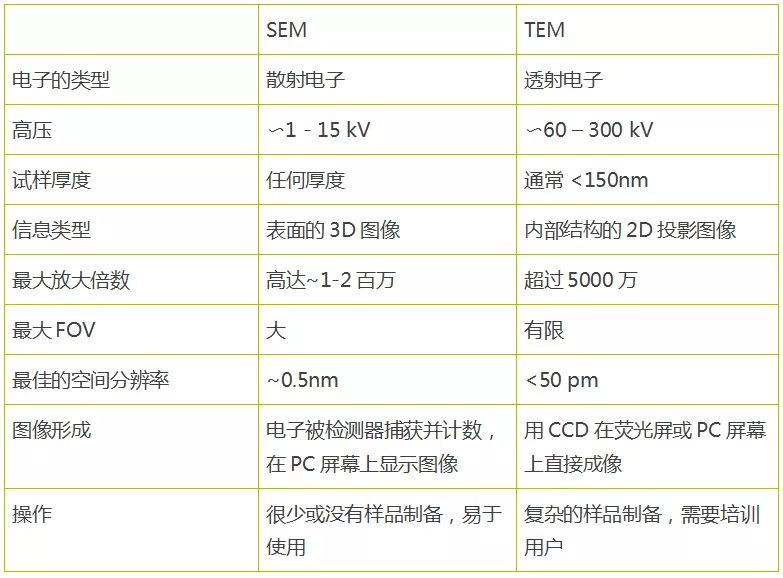
表 I:掃描電鏡(SEM)和透射電鏡(TEM)之間主要差異的總結
一般來說,,透射電鏡(TEM)的操作更為復雜,。 透射電鏡(TEM)的用戶需要經(jīng)過強化培訓才能操作設備。 在每次使用之前需要執(zhí)行特殊程序,,包括幾個步驟以確保電子束完美對中,。 在表 I 中,您可以看到掃描電鏡(SEM)和透射電鏡(TEM)之間主要區(qū)別的總結,。
結合 SEM 和 TEM 技術
還有一種電子顯微鏡技術被提及,,它是透射電鏡(TEM)和掃描電鏡(SEM)的結合,即掃描透射電鏡(STEM),。
在掃描透射電鏡(STEM)模式下工作時,,用戶可以利用這兩種技術的功能;他們可以在高分辨率先看到樣品的內(nèi)部結構(甚至高于透射電鏡 TEM 分辨率),但也可以使用其他信號,,如 X 射線和電子能量損失譜,。 這些信號可用于能量色散X射線光譜(EDX)和電子能量損失光譜(EELS)。
當然,,EDX 能譜分析在掃描電鏡(SEM)系統(tǒng)中也是常見分析方法,,并用于通過檢測樣品被電子撞擊時發(fā)射的 X 射線來識別樣品的成分。
電子能量損失光譜(EELS)只能在以掃描透射電鏡(STEM)模式工作的透射電鏡(TEM)系統(tǒng)中實現(xiàn),,并能夠反應材料的原子和化學成分,,電子性質(zhì)以及局部厚度測量。
在 SEM 和 TEM 之間做出選擇
從所提到的一切來看,,顯然沒有“更好”的技術; 這完全取決于需要的分析類型,。 當用戶想要從樣品內(nèi)部結構獲得信息時,透射電鏡(TEM)是最佳的選擇,,而當需要樣品表面信息時,,掃描電鏡(SEM)是首選。 當然,,主要決定因素是兩個系統(tǒng)之間的巨大價格差異,,以及易用性。 透射電鏡(TEM)可以為用戶提供更多的分辨能力和多功能性,,但是它們比掃描電鏡(SEM)更昂貴且體型較大,,需要更多操作技巧和復雜的前期制樣準備才能獲得滿意的結果。
相關產(chǎn)品
更多
相關文章
更多
技術文章
2025-06-03技術文章
2025-05-22技術文章
2025-05-21技術文章
2025-05-20
虛擬號將在 秒后失效
使用微信掃碼撥號