
復(fù)納科學(xué)儀器(上海)有限公司
 金牌會(huì)員
金牌會(huì)員 已認(rèn)證
已認(rèn)證

復(fù)納科學(xué)儀器(上海)有限公司
 金牌會(huì)員
金牌會(huì)員 已認(rèn)證
已認(rèn)證
AFM-SEM聯(lián)用技術(shù):半導(dǎo)體失效分析新突破(文末網(wǎng)絡(luò)研討會(huì)預(yù)告)
半導(dǎo)體是現(xiàn)代電子產(chǎn)品的基礎(chǔ),,支撐著從計(jì)算到數(shù)據(jù)存儲(chǔ)的一切功能。隨著器件尺寸縮小且結(jié)構(gòu)日益復(fù)雜,,精準(zhǔn)的失效分析變得至關(guān)重要。
AFM-in-SEM 失效分析:該技術(shù)直接集成于 FIB / SEM(聚焦離子束 / 掃描電鏡)環(huán)境,,能夠在納米尺度下對(duì)半導(dǎo)體元件進(jìn)行原位,、特定位置的電學(xué)與形貌表征。它提供精確的電導(dǎo)率映射和摻雜分布分析,,同時(shí)保持樣品完整性,。
? 核心優(yōu)勢(shì)
特定位置的失效分析: 利用 SEM 精確定位,結(jié)合高分辨率電導(dǎo)率與摻雜分布映射,。.
無(wú)縫真空工作流: 與現(xiàn)有失效分析工具完全兼容,,避免表面氧化和污染。.
探針保護(hù)與優(yōu)化接觸: 探針塢(Docking Station)在FIB銑削時(shí)保護(hù) AFM 探針,; 樣品旋轉(zhuǎn)功能優(yōu)化接觸角度,,適應(yīng)復(fù)雜幾何結(jié)構(gòu)。
省時(shí)與成本效益: 集成化方案減少單樣品測(cè)量時(shí)間,,加速研發(fā)進(jìn)程,。
樣品制備:使用 FIB 暴露缺陷區(qū)域,。
AFM 導(dǎo)航分析:在 SEM 引導(dǎo)下,AFM 探針定位目標(biāo)區(qū)域進(jìn)行高分辨率電學(xué)表征(如 C-AFM 或 SSRM),。
數(shù)據(jù)關(guān)聯(lián):將結(jié)果與 SEM 技術(shù)關(guān)聯(lián)(必要時(shí)校準(zhǔn)),,全面理解失效機(jī)制。

逐層剝離(Delayering): 通過(guò) PFIB 逐層剝離材料,,每層進(jìn)行局部電導(dǎo)率分析,,從而精確獲取不同深度的單層結(jié)構(gòu)信息。
校準(zhǔn): 對(duì)已知摻雜濃度的參考樣品進(jìn)行電阻測(cè)量,,測(cè)得的電阻隨后與摻雜水平相關(guān)聯(lián),,生成校準(zhǔn)曲線以定量分析摻雜濃度。
通過(guò) AFM-in-FIB/SEM 技術(shù),,對(duì) NAND 結(jié)構(gòu)中的特定通孔進(jìn)行以下分析:
識(shí)別通孔:使用等離子聚焦離子束(PFIB)逐層剝離材料
電學(xué)分析:導(dǎo)電原子力顯微鏡(C-AFM)映射:顯示不同深度節(jié)點(diǎn)的電導(dǎo)異常
I/V譜分析:通過(guò)單通孔的電流-電壓曲線診斷失效
實(shí)時(shí)監(jiān)控:在逐層剝離過(guò)程中實(shí)時(shí)觀察,,確保精確鎖定目標(biāo)通孔
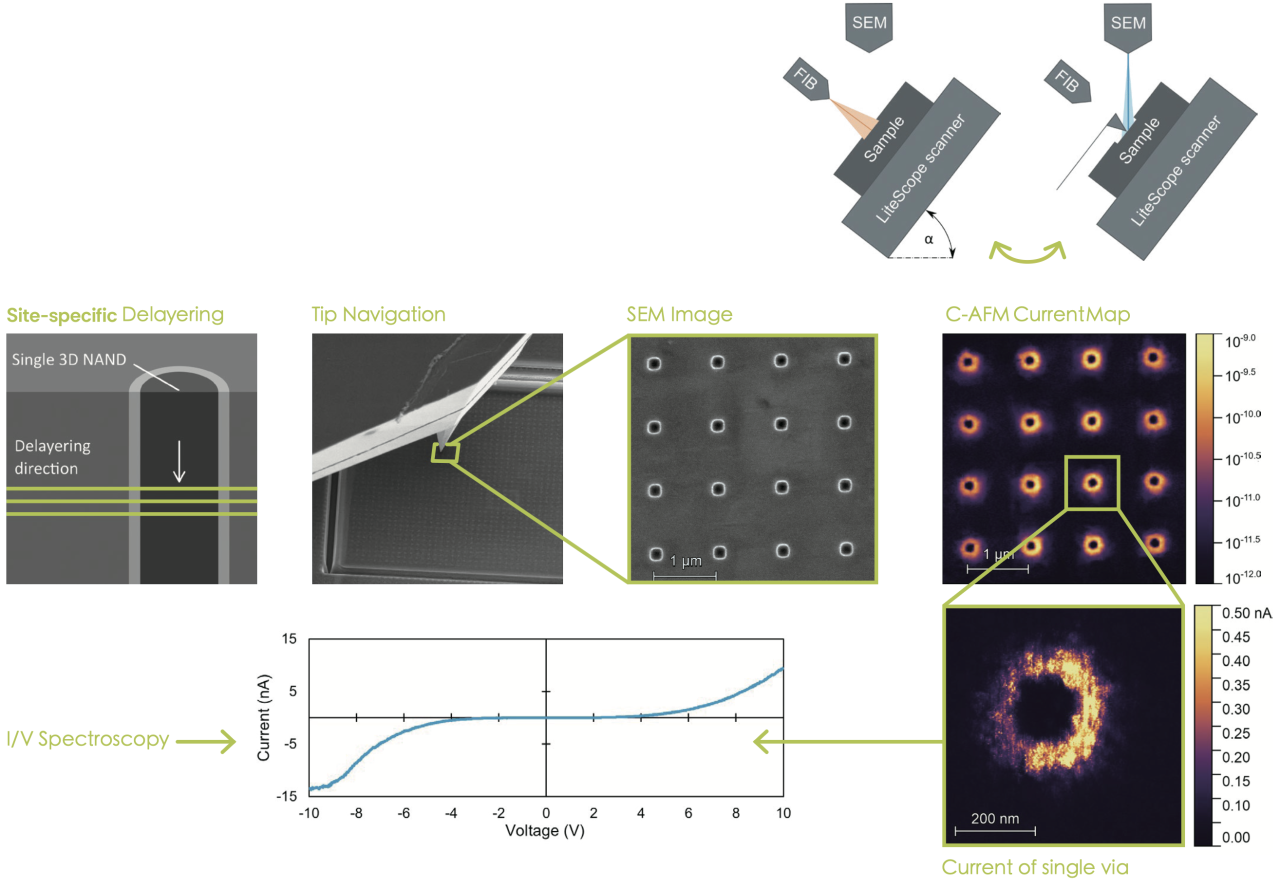
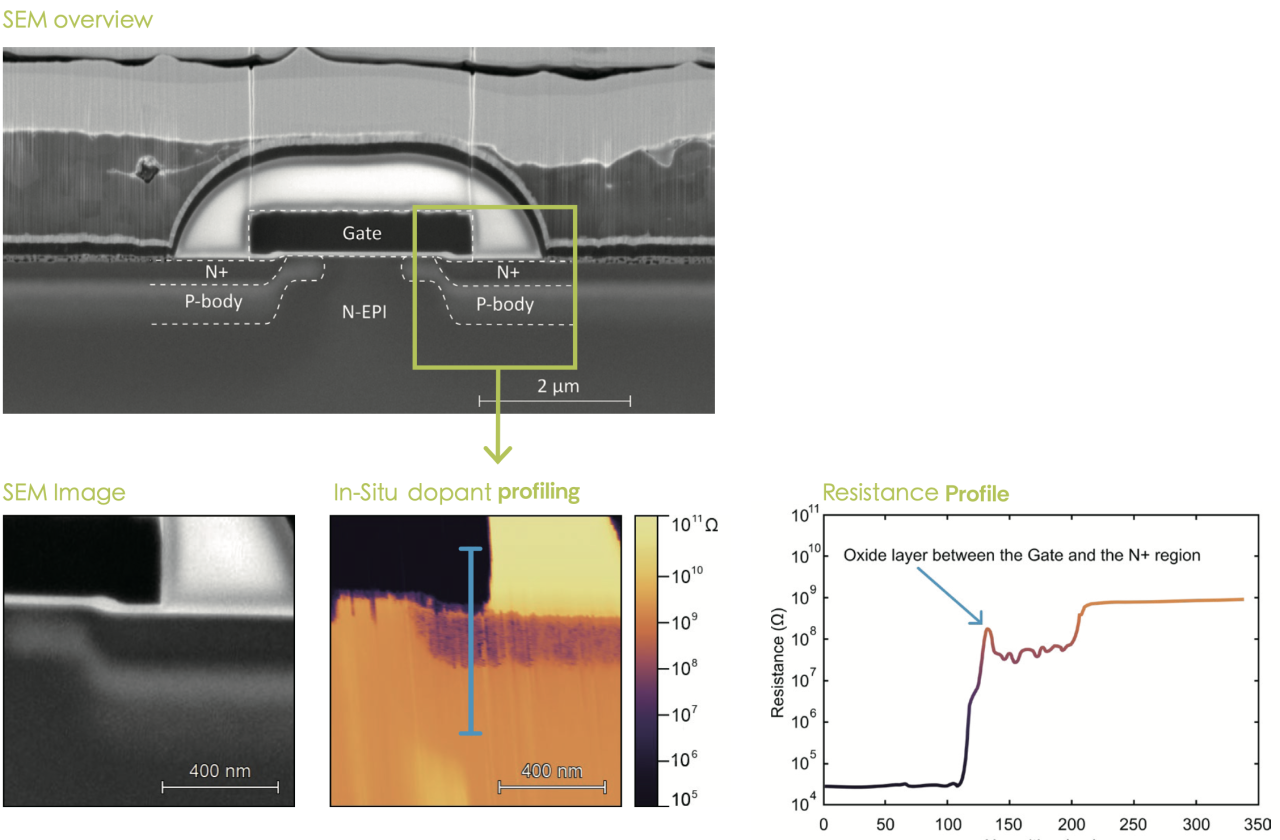
SEM 全局成像:我們采用掃描擴(kuò)展電阻顯微鏡(SSRM)結(jié)合掃描電子顯微鏡(SEM),對(duì)半導(dǎo)體器件中的摻雜濃度進(jìn)行了分析,,實(shí)現(xiàn)了高分辨率,、針對(duì)特定位置的電學(xué)特性表征。
原位 SEM-SSRM 測(cè)量:在納米尺度下映射摻雜濃度,,通過(guò)將掃描電鏡(SEM)成像與局部電學(xué)特性相結(jié)合,,我們能夠精確識(shí)別出摻雜濃度的空間差異,這些差異對(duì)器件的性能表現(xiàn)及可靠性具有決定性影響,。
對(duì) SiC MOSFET 的意義:直接表征摻雜層和結(jié)區(qū),,并分析器件結(jié)構(gòu)的精確形狀、尺寸與深度參數(shù),。確保導(dǎo)電性優(yōu)化,,減少能量損耗,提升器件可靠性與性能,。
更多案例分析,,敬請(qǐng)關(guān)注 2025 年 5 月 28 日《芯片內(nèi)部: AFM-SEM 聯(lián)用技術(shù)在電子半導(dǎo)體失效分析中的應(yīng)用》研討會(huì),。

相關(guān)產(chǎn)品
更多
相關(guān)文章
更多
技術(shù)文章
2025-06-03技術(shù)文章
2025-05-21技術(shù)文章
2025-05-20技術(shù)文章
2025-05-19
虛擬號(hào)將在 秒后失效
使用微信掃碼撥號(hào)