�Ї����w�W(w��ng)Ӎ ���b��ָ�������·оƬ���������Ԫ�����ض��IJ��Ϻ�ˇ�M(j��n)�а���,�����o(h��),��ʹ���c���h(hu��n)�����x,�����ṩ늚��B�Ӻ͙C(j��)е֧�ε��^��,��Ŀǰ���d����оƬ�Č��ü����·��ASIC�����bͨ�����ЙC(j��)����M��,���ЙC(j��)�����ɘ�֬����Ҫ�Dz�������(qi��ng)�h(hu��n)���Ӊ��壩�������Ƴ�,��
�ЙC(j��)����Ŀǰ�����N���Լ�ɢ���������Ć��},����оƬ�ܶ��^�ߵ��^����b�ߴ������׳��F(xi��n)�N��,���@�����Ʒ��b��(n��i)�ɷ��b��оƬ��(sh��)��,��Ҳ��Ӱ푷��b�����wƽ���Ⱥͷ�(w��n)����,�������m(x��)�ĽM�b��ʹ����ɲ���Ӱ푣��ЙC(j��)����ğጧ(d��o)�������^��,���ڶ���оƬ�ѯB�ȸ��ܶȷ��b��,�������y����Чɢ�l(f��)������(d��o)��оƬ�����ض�����,��Ӱ�оƬ�ķ�(w��n)����,���ɿ��Ժ����ܣ��L�ڸߜ�߀���ܿs��оƬ��ʹ�É���,�������IJ���������b���и�ƽ�����c�ʹֲڶ�,���᷀(w��n)���Ժ�,��늚����܃�(y��u)�������W(xu��)��(w��n)�����c�����g�ԏ�(qi��ng)�ȱ�����(y��u)��,�����S���ɞ��׃�ИI(y��)������,��
Ŀǰ������(n��i)�������M(j��n)���b�IJ������幤�S���߀δ�M(j��n)�����a(ch��n)�A��,������(sh��)��̎���аl(f��)�A��,���������弼�g(sh��)�mȻ���о�ĝ����̓�(y��u)�ݣ���Ҫ��(sh��)�F(xi��n)�������M(j��n)���b�I(l��ng)��ďV����(y��ng)��,������˷����༼�g(sh��)����(zh��n),��
�߾���ͨ��
����ͨ���g(sh��)(TGV)��һ�N�ڲ������������촹ֱ늚⻥�Bͨ���ļ��g(sh��)��ͨ�^�ڲ��������о��_���,�����ڿױ��ϳ��e��(d��o)늽��ٌ�,����(sh��)�F(xi��n)����늚���̖�Ļ��B������ͨ���Ƃ���Ҫ�M�����,���߾���,��խ��(ji��)�ࡢ��(c��)�ڹ⻬,����ֱ�Ⱥ��Լ��ͳɱ���һϵ��Ҫ��,������Ƃ����(y��u)���IJ���ͨ��һֱ�Ƕ�����о����������ġ�Ŀǰ�����IJ���ͨ�ӹ����ͷ����Ї�ɰ��,���۽���늷�,�����x�ӿ��g����������g��,��늻��W(xu��)��늷�,�������������������T��(d��o)���g����,��

��ͬ����ͨ���Ƃ䷽�� ��Դ���V�l(f��)�Cȯ
�C�ϱ��^���N����ͨ�����켼�g(sh��),�������T��(d��o)���g�����еͳɱ���(y��u)�ݣ��д�Ҏ(gu��)ģ��(y��ng)��ǰ��,��Ȼ��,���M�܆������������������^�麆�Σ�����(d��ng)��(sh��)�����ӵ���(sh��)ʮ�f���r,���y�ȕ��Ԏμ���(sh��)���L,���@Ҳ���S��ͨ��δ���_(d��)���A(y��)��Ч����ԭ��֮һ������,����Μyԇÿ��ͨ�����ʻ�ߴ羫��,��Ҳ����Ҫ���]�Ć��}��
���|(zh��)���M(j��n)������
���˳ɿ��g(sh��)��,����һ�����g(sh��)�y�c(di��n)�Ǹ��|(zh��)���Ľ������,������ͨ���Πͬ,����Ҫ��ä�ס���ֱͨ��,��X��ͨ���Լ�V��ͨ���ķN���,����ͬ��ͨ���~�ij��e��(g��u)�����^�������(zh��n)�������γɿġ�������,����һ����,���c�������ȣ����ڲ�������⻬,���c���ý��ٵ�ճ�����^��,��������ɲ����r���c���ٌ�֮�g�ķӬF(xi��n)��,����(d��o)�½��ٌӾ�������Ó��ĬF(xi��n)��,��
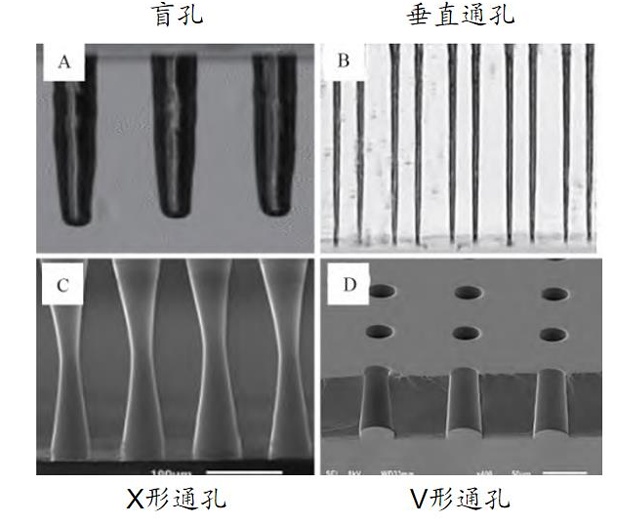
��Դ:����ͨ�����S���B��~��似�g(sh��)�l(f��)չ�F(xi��n)��
����������ܶȲ���
����ɲ���ͨ���Ƃ����Ҫ�ڲ�����������M(j��n)�в����팍(sh��)�F(xi��n)��(li��n)��ͨ��늚��B��,���������ЙC(j��)�r����,����������Ĵֲڶ�С�������ڲ����Ͽ����M(j��n)�и��ܶȵIJ�������,�����y(t��ng)�Ĺ�ˇ����������ӳɷ�,���Լ����F(xi��n)�е��ЙC(j��)�����·����ģʽ��(y��ng)�õ����������ϣ������ЙC(j��)�Ę�֬���D(zhu��n)���鲣�����e�Č����ṩ֧��,���������քt�����������ЙC(j��)�����僌���������,�����ͨ�^�M(j��n)һ���ĉ��ϻ�������ˇ�M(j��n)�����ϡ������ڰ�ӳɹ�ˇ���ھ���С��5��m�ĕr������R�S������(zh��n),��������խ�g����(n��i)���g�N�ӌ������~�߾���ɓp����խ�g����ķN�ӌӚ��������©�,�����ᘌ���������ı�����ܶȲ������W(xu��)��͘I(y��)��Ҳ�ڏV��̽�������M(j��n)�ļ��g(sh��),��
������Դ��
����.���S���ɷ��b�й�������ͨ���Ƃ乤ˇ�о�
�o(j��)��(zh��)��.����ͨ�����S���B��~��似�g(sh��)�l(f��)չ�F(xi��n)��
���.����ͨ���g(sh��)�о��M(j��n)չ
�V�l(f��)�Cȯ�l(f��)չ�о�����
(�Ї����w�W(w��ng)������/����)
ע:�DƬ���̘I(y��)��;,�������֙�(qu��n)��֪�h��!