�Ї�(gu��)���w�W(w��ng)Ӎ ����ӷ��b�^(gu��)����,���մɻ������P(gu��n)�I�����������մɻ���IJ����ʌ�(du��)�����������|(zh��)�������ش�����x,�������մɻ������ܙz�y(c��)�Пo(w��)��(gu��)�һ��ИI(y��)��(bi��o)��(zh��n),���@�o��I(y��)���a(ch��n)�ͮa(ch��n)Ʒ�ƏV����(l��i)һ�����y��
Ŀǰ,����Ҫ���ܰ����������^,�����W(xu��)���ܡ���W(xu��)����,��늌W(xu��)����,�����b����(��������)�Ϳɿ��Եȡ�
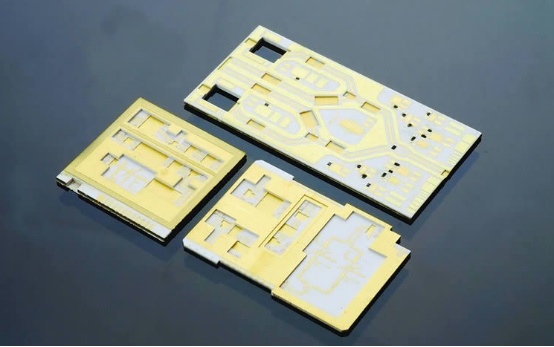
���DƬ��(l��i)Դ����늿���ʮ������
���^�z�y(c��)
���^�z��һ���ȡĿҕ���@�R,���z�y(c��)�մɻ�������Ƿ����ѿp,���������ٌӱ����Ƿ��й�,������,�����c(di��n)���|(zh��)��ȱ�ݡ�����,���մɻ�Ƭ��С�c���,�����ٌӺ�ȣ��������ƽ���ȣ��N����,���������D�ξ��ȶ�����Ҫ���c(di��n)�z�y(c��)�ă�(n��i)��,���e�nj�(du��)�ڲ��õ��bоƬ�����ܶȷ��b����,��һ��Ҫ�����ƽ���ȵ���3%,���D�ξ��ȃ�(y��u)��30��m��
�����(l��i),���S��Ӌ(j��)��C(j��)���g(sh��)�͈D��̎�����g(sh��)����l(f��)չ,����I(y��)�ù��ɱ���������,����I(y��)������I(y��)�D(zhu��n)������(j��)��Խ��(l��i)Խ��ҕ�˹����͙ܺC(j��)��ҕ�X(ju��)�ȼ��g(sh��)�đ�(y��ng)�ã����ڙC(j��)��ҕ�X(ju��)�ęz�y(c��)�������O(sh��)����u�ɞ������a(ch��n)Ʒ�|(zh��)��,�������Ʒ�ʵ���Ҫ�ֶ�,����ˣ����C(j��)��ҕ�X(ju��)�z�y(c��)������(y��ng)�����մɻ���ęz�y(c��),������ߙz�y(c��)����,�����������ɱ����������õđ�(y��ng)�Ãr(ji��)ֵ,��
���W(xu��)���ܙz�y(c��)
ƽ���մɻ������W(xu��)������Ҫָ���پ�·�ӽY(ji��)�Ϗ�(qi��ng)��,����ʾ���ٌ��c�մɻ�Ƭ�g��ճ�ӏ�(qi��ng)�ȣ�ֱ�ӛQ���˺��m(x��)�������b�|(zh��)��(�̾���(qi��ng)���c�ɿ��Ե�),����ͬ�����Ƃ���մɻ���Y(ji��)�Ϗ�(qi��ng)�Ȳ�e�^��,��ͨ�����øߜع�ˇ�Ƃ��ƽ���մɻ���(��TPC��DBC��),������ٌ��c�մɻ�Ƭ�gͨ�^(gu��)���W(xu��)�I�B��,���Y(ji��)�Ϗ�(qi��ng)���^�ߣ����͜ع�ˇ�Ƃ���մɻ���(��DPC����),�����ٌ��c�մɻ�Ƭ�g��Ҫ�Է����A�����C(j��)еҧ��������,���Y(ji��)�Ϗ�(qi��ng)��ƫ�͡����ýY(ji��)�Ϗ�(qi��ng)�Ȝy(c��)ԇ����������
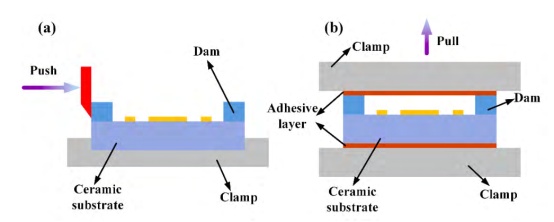
���Џ�(qi��ng)�Ȝy(c��)ԇʾ��D/���쏊(qi��ng)�Ȝy(c��)ԇʾ��D
(1)�z���������z���o�N���ٌӱ���,������Ƥ�LͲ������L��,����ȥ��ճ�����(n��i)���ݡ�10s���ô�ֱ�ڽ��ٌӵ�����ʹ�z�����x,���z�y(c��)���ٌ��Ƿ�Ļ�Ƭ�τ��x,������һ�N���Ԝy(c��)ԇ������
(2)���������x��ֱ����0.5mm��1.0mm�Ľ��پ�,��ͨ�^(gu��)�����ۻ�ֱ�Ӻ����ڻ�����ٌ���,���S��������Ӌ(j��)�ش�ֱ����y(c��)�����پ���������
(3)���x��(qi��ng)�ȷ������մɻ��������ٌ��g��(����)��5mm��10mm�L(zh��ng)�l,��Ȼ���ڄ��x��(qi��ng)�Ȝy(c��)ԇ�C(j��)���ش�ֱ����˺��,���y(c��)ԇ�䄃�x��(qi��ng)�ȡ�Ҫ���x�ٶȞ�50mm/min,���y(c��)���l�ʞ�10��/s,��
��W(xu��)����
�մɻ����W(xu��)������Ҫ�����ጧ(d��o)�ʡ��͟���,������Ûϵ��(sh��)�͟����,���մɻ������������b����Ҫ��ɢ�����ã������ጧ(d��o)������Ҫ�ļ��g(sh��)ָ��(bi��o)���͟�����Ҫ�y(c��)ԇ�մɻ����ڸߜ����Ƿ��N��,��׃��,��������پ�·���Ƿ�����׃ɫ�����ݻ�Ó��,����(n��i)��ͨ���Ƿ�ʧЧ��,�������մɻ���һ�����ӽY(ji��)��(g��u)���䌧(d��o)�����Բ��H�c�մɻ�Ƭ���ϟጧ(d��o)�����P(gu��n)(�w����),��߀�c���Ͻ���Y(ji��)����r�������P(gu��n)(������|����),����ˣ����ß���y(c��)ԇ�x(�ɜy(c��)�����ӽY(ji��)��(g��u)���w����ͽ������)����Ч�u(p��ng)�r(ji��)�մɻ��匧(d��o)������,��
늌W(xu��)����
�մɻ���늌W(xu��)������Ҫָ������������ٌ��Ƿ�(d��o)ͨ(��(n��i)��ͨ���|(zh��)���Ƿ�����),������DPC�մɻ���ͨ��ֱ���^С��������וr(sh��)��(hu��)���F(xi��n)δ�(sh��),�����ȱ��,��һ��ɲ���X�侀�y(c��)ԇ�x(���ԣ�����)���wᘜy(c��)ԇ�C(j��)(����,������)�u(p��ng)�r(ji��)�մɻ���ͨ���|(zh��)����
���b����
�մɻ�����b������Ҫָ�ɺ����c������(�����S�մɻ���),������������I�Ϗ�(qi��ng)��,��һ�����մɻ�����ٌӣ��e�Ǻ��P(p��n)�������僻W(xu��)�һ��Au��Ag�Ⱥ����������õĽ��٣���ֹ����,����������I���|(zh��)��,���ɺ���һ������X�����әC(j��)������Ӌ(j��)�M(j��n)�Мy(c��)��,��
��оƬ�N�b�����S�մɻ���ǻ�w��(n��i),�����w��(���ٻ���)��ǻ�w�ܷ��Ɍ�(sh��)�F(xi��n)�������ܷ��b�����β����c���Ӳ��Ϛ�����ֱ�ӛQ�����������b������,����ͬ�����Ƃ�����S�մɻ�������Դ���һ���,����(du��)���S�մɻ�����Ҫ�y(c��)ԇ���β����c�Y(ji��)��(g��u)�Ě����ԣ���Ҫ�з��͚��ݷ��ͺ��|(zh��)�V�x��,��
�ɿ��Ԝy(c��)ԇ�c����
�ɿ�����Ҫ�y(c��)ԇ�մɻ������ض��h(hu��n)����(�ߜ�,���͜ء��ߝ�,��ݗ��,�����g�����l���(d��ng)��)������׃��,����Ҫ��(n��i)�ݰ����͟���,���ߜش惦(ch��)���ߵ͜�ѭ�h(hu��n)����_��,�����g,�������g�����l���(d��ng)��,����(du��)��ʧЧ��Ʒ,���ɲ���������R(SEM)��X�侀����x(XRD)�քe�M(j��n)���^�ͳɷַ��������Ò����@�R(SAM)��X�侀�z�y(c��)�x�M(j��n)�к��ӽ����ȱ�ݷ���,��
������(l��i)Դ��
[1]�̺�,��������.��ӷ��b�մɻ���
[2]�̺ƣ�������.������ӷ��b���մɻ��弼�g(sh��)�c��(y��ng)���M(j��n)չ
[3]�S˼��.����HALCON��LED�մɻ���ȱ�ݙz�y(c��)ϵ�y(t��ng)
���Ї�(gu��)���w�W(w��ng)������/ɽ����
ע���DƬ���̘I(y��)��;,�������֙�(qu��n)��֪?ji��ng)h��




















