���W(xu��)�C(j��)е����Һ��Ӱ푒����|(zh��)���͒���Ч�ʵ��P(gu��n)�I����֮һ��������Һ�е�ĥ�����������Q���˒���Һ�ĸ�헻��W(xu��)�C(j��)е��������,��
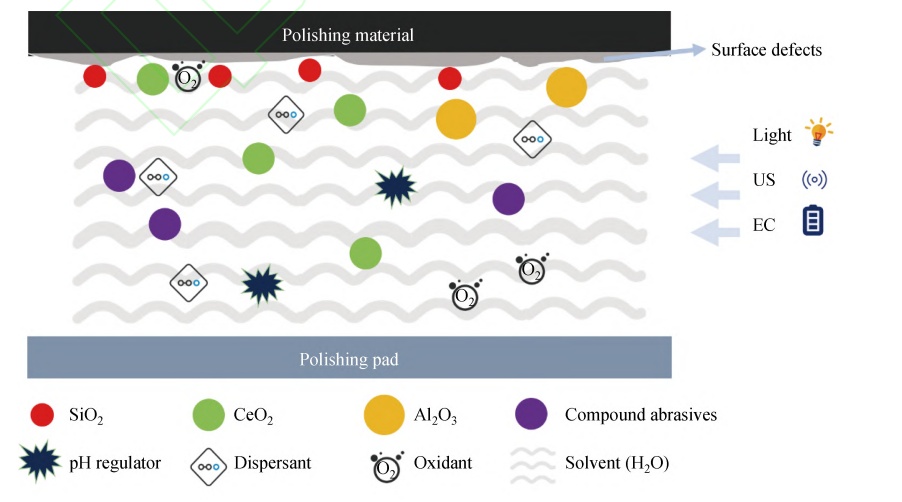
���W(xu��)�C(j��)е����Һ���M�� ��Դ�����|�ܵ�,�����W(xu��)�C(j��)е����Һ���о��F(xi��n)��
�ڒ����^���У�����Һ�еĻ��W(xu��)���ӄ��Ͳ��ϱ���l(f��)������(y��ng),�����ڱ�������ϱ����γ�һ�Ӻܱ�,���Y(ji��)�����^���ġ�ܛ���ӡ���֮��ĥ���ډ�����Ħ�����������ϱ����M(j��n)�м�(x��)�o�p��ȥ��,��CMP�ڼ����·�����ǰ������FEOL��,���е�����MOL�����������BEOL����Ҫ����N��ͬ���ϣ���SiO2,��Cu,��Co��W,����K���|(zh��)�ȣ��M(j��n)��ƽ̹��,�����ˌ��F(xi��n)��Ч�o�p�Ē��⣬�_�l(f��)����SiO2,��CeO2,������ʯ��Al2O3����ĥ���Ē���Һ,�������ڲ�ͬ���ϵ�ȥ����������Ҫ������,��
����Һ��ĥ������ʽ����
һ����һĥ��
��һĥ������Һ��ָ�ڒ���Һ��ֻ���ж������裨SiO2��,�������X��Al2O3��,������⋣�CeO2��������䆣�ZrO2��,���{����ʯ�ȱ��ೣ��ĥ��֮һ,������SiO2��Al2O3��CeO2�Ǒ�(y��ng)����V����,��
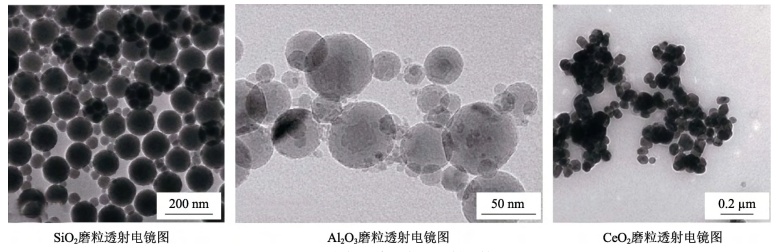
���N���Æ�һĥ������R�D ��Դ���Ϸ�����,�����W(xu��)�C(j��)е����Һ���о��M(j��n)չ
SiO2�������õķ�(w��n)���Ժ͑Ҹ��ԡ����Ⱥ͵�Ӳ�ȣ�ƽ������Ӳ�Ȟ�7�������c,�����V����(y��ng)�Þ钁��Һĥ��,�����ǣ�SiO2�F(tu��n)��,�����m���L�ڱ���,��Ӳ���^�ͣ���(d��o)�������ʟo��ͻ�Ƹ�Ч��ƿ�i,��
Al2O3�{����Ӳ�ȸ�,����(w��n)���Ժõ���(y��u)�c���V����(y��ng)�����{(l��n)��ʯ,��̼����Ȳ��ϵ�CMP���g(sh��)��,������Al2O3�ă��Ի��W(xu��)���|(zh��)��Al2O3����Һ�֞�A�Ԓ���Һ�����Ԓ���Һ,���c�A�Ԓ���Һ��ȣ����Ԓ���Һ���O(sh��)��ĸ��g�����(y��n)��,�����ԉA�Ԓ���Һ�����Ԓ���Һ��(y��ng)�ø��V��,����Al2O3ĥ����ˮ��Һ�������o������������F(tu��n)�۳ɴ��w���z�F(tu��n)�����F(xi��n)�����ӵȬF(xi��n)��,����(d��o)����Һ��(w��n)�����^��,����ˣ�ʹ��Al2O3���钁��Һĥ��,����Ҫ�ڒ���Һ�м�����N���ӷ�(w��n)��������ɢ��,��ʹ�Ì�����C(j��)�����о����ӏ�(f��)�s��ͬ�r����Һ�ijɱ�Ҳ�S֮����,��
����CeԪ�صĶ��r�B(t��i)�������D(zhu��n)������,�����������c����Һ���|�����|(zh��)���ױ��������γɽj(lu��)���������ȥ��ʹ��CeO2�ڲ������ϻ��W(xu��)�C(j��)е����չ�F(xi��n)����(y��u)��������,���c���y(t��ng)����Һĥ������^,��CeO2ĥ������Һ���В���Ч�ʸߡ��❍�Ⱥú͉����L�ȃ�(y��u)�c,����������Ce����ϡ�н���,�������Ƃ�CeO2ĥ����ˇ��(f��)�s�����ʹ�ô���CeO2ĥ������Һ�ɱ��ܸ�,������,���F(xi��n)�м��g(sh��)�Ƃ��CeO2ĥ�����ߴ緶������^��(d��o)�����|(zh��)������(w��n)��,��
���چ�һĥ�����������ܵľ�����,��ʹ�Æ�һĥ������Һ���F(xi��n)�˺ܶ��y�Խ�Q��ƿ�i���}�����,���ܶ��о��ˆT�D(zhu��n)���о����ĥ������Һ�͏�(f��)��ĥ������Һ,�������ڽ�Q���W(xu��)�C(j��)е�����^���мӹ�Ч�ʺͼӹ��|(zh��)����ƽ�↖�}��
��,�����ĥ��
���ĥ����Ҫָ�В��^����ʹ�ÃɷN���N��ͬĥ����������ϵ�ĥ��,������ĥ���IJ�ͬ��Ҫ�w�F(xi��n)����|(zh��)�������ȷ���IJ�ͬ��
Jindal�Ȍ��^��������Al2O3ĥ���քe�c�^С������SiO2,��CeO2��ĥ���M(j��n)�л��,�����F(xi��n)�ˌ���һĥ���В����ܵ�������ͨ�^�@��ò�����@ʾ�ڴ�������ĥ����������M��С������ĥ��,������ڼ�Al2O3ĥ��,������������SiO2��CeO2�Ļ��ĥ�����ȿ��Ա��⼃Al2O3ĥ���ĈF(tu��n)��,��߀��������С����ĥ���Ļ��W(xu��)���ԁ��������ĥ�����В�Ч��,��
�mȻ���ĥ��������ߒ���Ч���кܴ�Ĵ��M(j��n)���ã����������|(zh��)����Ӱ푲��Ǻ����@,�������ֹ,��߀�]�аl(f��)�F(xi��n)��ͬ��������ͬ��ò����ͬ�N�ĥ�,����ʹ�Ì�����Y(ji��)����Ӱ�Ҏ(gu��)��,��ᘌ����ĥ�����о���������Ҫ�M(j��n)һ�����M(j��n)��
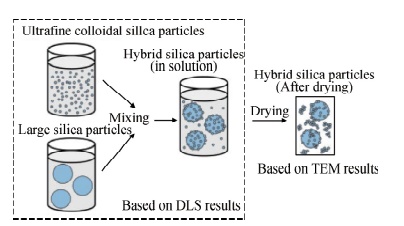
���ĥ���ϳ�ʾ��D
��Դ��BUN-ATHUEK N, et al. Effects of mixed ultrafine colloidal silica particles on chemical mechanical polishing of sapphire��
��,����(f��)��ĥ��
�����,���S������W(xu��)���ڲ�ͬ�I(l��ng)��ďV����(y��ng)�ã�ʹ�û��W(xu��)�ֶ��Ƃ��(f��)�ϻ��W(xu��)�C(j��)е����Һĥ��Ҳ�õ������l(f��)չ,���c���ĥ����ͬ,����(f��)��ĥ�������ض��ėl���£�ͨ�^һ���Ļ��W(xu��)����(y��ng)�����ɵ�,����õķ����Ǽ{���w���İ����͓��s,��
�˚��͏�(f��)��ĥ���ă�(n��i)�˞��������ĥ������,���⚤��ͨ�^���W(xu��)��ʽճ�Y(ji��)�ڃ�(n��i)�˱����С����ĥ���ӻ����,�����В��^���У��˚��͏�(f��)��ĥ���ĺ��c�����F(xi��n)�������ͻ��W(xu��)����ąf(xi��)ͬЧ��(y��ng),���������������В��|(zh��)��,������,����(f��)��ĥ����(n��i)�˞��^Ӳ�Ĵ�����ĥ������Ҫؓ(f��)؟(z��)֧�����w�Y(ji��)��(g��u),���⚤���^ܛ��С����ĥ��,����Ҫؓ(f��)؟(z��)����������ϵ�ȥ������Ȇ�һӲ�ȵČ���ĥ���Y(ji��)��(g��u),��ԓ��(f��)��ĥ�����С���(n��i)Ӳ��ܛ���ĽY(ji��)��(g��u)���c,��������������ĥ�����В����ܡ�
���s�͏�(f��)��ĥ��ָ��ijһĥ�����d�w,��ͨ�^���W(xu��)��ʽ������Ԫ��?f��)������ж��γɵď?f��)��ĥ��,��ԓ��(f��)��ĥ����������ԭĥ���ı��滯�W(xu��)����,���@�ø��õ��В�����,��
��2010����Chen�Ȍ�SiO2,��CeO2,���۱���ϩ�;ۼ���ϩ������Ȳ����Ƃ��˶�N��ͬ���ϡ���ͬ�ߴ�,����ͬ�Y(ji��)��(g��u)�Ě�/�˽Y(ji��)��(g��u)��(f��)�ϲ���ĥ��,����ᘌ���Ƭ�M(j��n)���˴�������ԇ������֪,��ʹ�Ï�(f��)�ϲ���ĥ���r,��CeO2/SiO2����Ч����ߣ�PS/CeO2�����|(zh��)�����,��
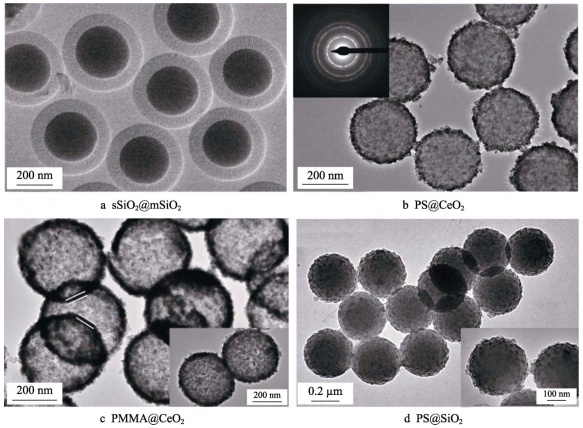
��-���Y(ji��)��(g��u)��(f��)��ĥ������R�D ��Դ���Ϸ����ȣ����W(xu��)�C(j��)е����Һ���о��M(j��n)չ
��(f��)��ĥ����Ȼ��ĥ���͆�һĥ��,���ڲ���ȥ���ʼ�����ֲڶȷ���������@�ă�(y��u)��,���܌��F(xi��n)�{���{�����͓p���ı�����ò������(f��)��ĥ�����Ƃ乤ˇ�������^��(f��)�s,�����x��(f��)��ĥ���ڴ�Ҏ(gu��)ģ���a(ch��n)�ϵđ�(y��ng)��߀���^�h(yu��n)�ľ��x,��
δ�����費��̽��
�S��ĥ���ڒ���Һ�еķ�ɢ��(w��n)������Ӱ푒���Һ�ܷ��L�ڱ�����P(gu��n)�I���ء�Ŀǰ�о��߂�ͨ�^��׃ĥ�����������|(zh��)����?j��n)?sh��),����Һ�м�����N���ӄ��ȷ�������(qi��ng)ĥ���ڒ���Һ�еķ�ɢ��(w��n)����,�����L����Һ�ı���r�g��Ȼ��,��ͨ�^���ӄ������ĥ���ķ�ɢ��(w��n)�����Դ���һЩ���},�����磬���ӄ���������ܕ�Ӱ푒����|(zh��)��,��߀��������y��ϴ���g�O(sh��)��Ć��},�����⣬Ŀǰ�܉��m�䒁��Һ�����ӄ��N��������^�١�
δ��,������������(y��u)��ĥ�����|(zh��),���_�l(f��)�m�õ����ӄ���̽���h(hu��n)���������,�����õ��ƄӒ��ˇ�İl(f��)չ,��
������Դ��
[1] �Ϸ����ȣ����W(xu��)�C(j��)е����Һ���о��M(j��n)չ
[2] ���|�ܵ�,�����W(xu��)�C(j��)е����Һ���о��F(xi��n)��
[3] �S����,��CeO2��ĥ���ڻ��W(xu��)�C(j��)е�����е��о��M(j��n)չ
[4] ��̵ȣ����W(xu��)�C(j��)е���⼼�g(sh��)�о��F(xi��n)��l(f��)չڅ��
[5] �����h��,�������ܱ����В�ĥ�����о��M(j��n)չ
[6] �̼ь���,��CMP����Һ��SiO2ĥ����ɢ��(w��n)���Ե��о��M(j��n)չ
[7] JINDAL A, et al. Chemical mechanical polishing using mixed abrasive slurries.
[8] JINDAL A, et al. Chemical mechanical polishing of dielectric films using mixed abrasive slurries��
[9] BUN-ATHUEK N, et al. Effects of mixed ultrafine colloidal silica particles on chemical mechanical polishing of sapphire��
���Ї����w�W(w��ng)������/ɽ�֣�
ע���DƬ���̘I(y��)��;�������֙�(qu��n)��֪�h��,��




















