中國粉體網(wǎng)訊 隨著半導(dǎo)體技術(shù)的飛速發(fā)展,碳化硅(SiC)作為一種卓越的高性能材料,,正日益成為科研界關(guān)注的焦點,。然而,其卓越的硬度和化學(xué)穩(wěn)定性特性,,在為材料帶來優(yōu)勢的同時,,也給拋光工藝設(shè)置了重重難關(guān),。特別是在晶圓的精密制造環(huán)節(jié)中,傳統(tǒng)的化學(xué)機械拋光(CMP)方法遭遇了嚴(yán)峻挑戰(zhàn),,包括如何有效消除表面缺陷以及提升材料去除效率等關(guān)鍵問題亟待解決,。
近日,日本立命館大學(xué)(Ritsumeikan University)一研究團隊開發(fā)了一種新型的ECMP(電化學(xué)機械拋光)技術(shù),,實現(xiàn)了約15μm/h的材料去除率,,使得SiC拋光得到大幅度提升,。
該團隊開發(fā)的這種技術(shù),,在拋光過程中,碳化硅襯底作為陽極,,與拋光板(陰極)之間夾著SPE/CeO2復(fù)合材料襯墊,。當(dāng)施加偏置電壓時,碳化硅表面與SPE發(fā)生電解反應(yīng),,形成一層易于去除的氧化膜,,這層氧化膜隨后被襯墊中的CeO2顆粒去除。
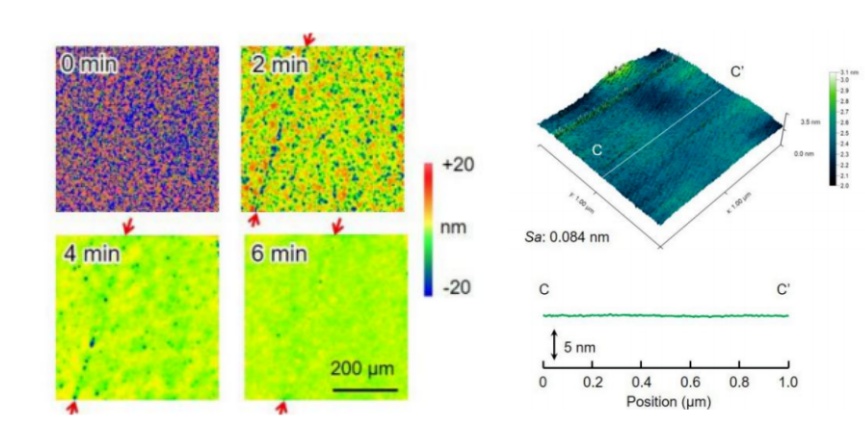
ECMP對碳化硅表面形態(tài)的改變(左),、經(jīng)ECMP處理的碳化硅(0001)表面的AFM圖像(右)
該技術(shù)的優(yōu)勢在于:
環(huán)保高效:ECMP技術(shù)避免了使用有害的液體化學(xué)物質(zhì),,減少了對環(huán)境的影響;
高去除率:該技術(shù)實現(xiàn)了約15μm/h的材料去除率(MRR),,是傳統(tǒng)CMP的10倍,;
質(zhì)量高:通過ECMP處理的碳化硅襯底表面光滑,粗糙度可降至亞納米級別,。
什么是ECMP,?
目前化學(xué)機械拋光的材料去除率以及加工后的表面粗糙度,已經(jīng)很難通過改變工藝取得大的突破,。在CMP拋光的基礎(chǔ)上施加增效輔助,,成為了近些年大幅度提高材料去除率和降低表面粗糙度的最優(yōu)選擇。
ECMP是一種利用電解液作為拋光液,,將工件的電化學(xué)腐蝕與機械拋光相結(jié)合的精密工藝,。在單晶SiC (作為陽極)表面帶電后通過陽極氧化產(chǎn)生氧化層,然后用軟磨料機械去除氧化層,,最后獲得超光滑無損傷的表面,。該技術(shù)方法通常用于產(chǎn)生難以通過機械拋光實現(xiàn)的光澤的表面。
但采用這種方法時,,若陽極電流較弱,,則加工表面質(zhì)量較好,但材料去除率變化不大,;若陽極電流較強,,則材料去除率顯著提高,,但陽極電流過強會導(dǎo)致表面精度下降及多孔現(xiàn)象。由此可見,,對化學(xué)機械拋光施加外電場進行電化學(xué)機械拋光時,,試件表層的氧化速率和材料去除率相協(xié)調(diào)的問題,是高效獲得光滑表面的關(guān)鍵點,。
該團隊在實驗過程中,,首先研究了電解電流密度對碳化硅襯底材料去除率的影響,發(fā)現(xiàn)MRR與電解電流密度成正比,,且在一定的電流密度下達到飽和:在電解電流密度低于10 mA/cm2時,,MRR隨電流密度的增加而增加,超過15 mA/cm2后,,MRR達到飽和狀態(tài),,法拉第效率開始下降,表明電流密度的進一步提高并沒有帶來更高的材料去除效率,。
目前看來,,CMP不管是在實驗原理上,還是在實驗設(shè)置上,都是最簡單,、最容易實現(xiàn)的,。但拋光液通常含有強酸或者強堿以及強氧化劑,對環(huán)境以及實驗者會產(chǎn)生危害,,而且其拋光效率已到了瓶頸,。
像ECMP這類型的增效化學(xué)機械拋光也得到了越來越多的關(guān)注,隨著SiC器件應(yīng)用范圍的不斷擴大,,對SiC襯底的加工效率及表面質(zhì)量也提出了更高的要求,。此項新技術(shù)不僅滿足加工效率及表面質(zhì)量的保證,還為SiC襯底制造綠色發(fā)展注入了新力量,。
來源:
行家說三代半
田壯智等:單品SiC超精密加工研究進展
(中國粉體網(wǎng)編輯整理/空青)
注:圖片非商業(yè)用途,,存在侵權(quán)告知刪除



















