中國粉體網訊 近年來 IT 技術飛速發(fā)展,,越來越多的器件被要求封裝在更小的空間內,,并且運算速度對器件的工作頻率提出了更高的要求,,使得電子器件在工作時的熱流密度迅速升高,,從而溫度也會不斷升高,。這需要采取有效的散熱措施,。

圖片來源:pixabay
迄今為止,,金剛石是已知材料中熱導率最高的,并且其熱膨脹系數很低,,具有良好的電絕緣性,,非常符合電子封裝材料的應用要求。既然如此,,很多人開始研究如何將金剛石這些優(yōu)點應用到電子器件的散熱中去,。
早在2014年,華為技術團隊便與廈門大學電子科學與技術學院于大全教授團隊在Journal of Materials Science & Technology上發(fā)表了“基于反應性納米金屬層的金剛石低溫鍵合技術”成果,。近日,,華為技術團隊與于大全、鐘毅老師團隊,、廈門云天團隊合作在先進封裝玻璃轉接板集成芯片-金剛石散熱技術領域又取得突破性進展。
成果顯示,,合作團隊克服了微凸點保護,、晶圓翹曲等行業(yè)難題,成功將多晶金剛石襯底集成到2.5D玻璃轉接板(Interposer)封裝芯片的背面,,并采用熱測試芯片(TTV)研究其散熱特性,。利用金剛石的超高熱導率,,在芯片熱點功率密度為~2 W/mm2時,集成金剛石散熱襯底使得芯片最高結溫降低高達24.1 ℃,,芯片封裝熱阻降低28.5%,。先進封裝芯片-金剛石具有極為優(yōu)越的散熱性能,基于金剛石襯底的先進封裝集成芯片散熱具有重大的應用前景,。
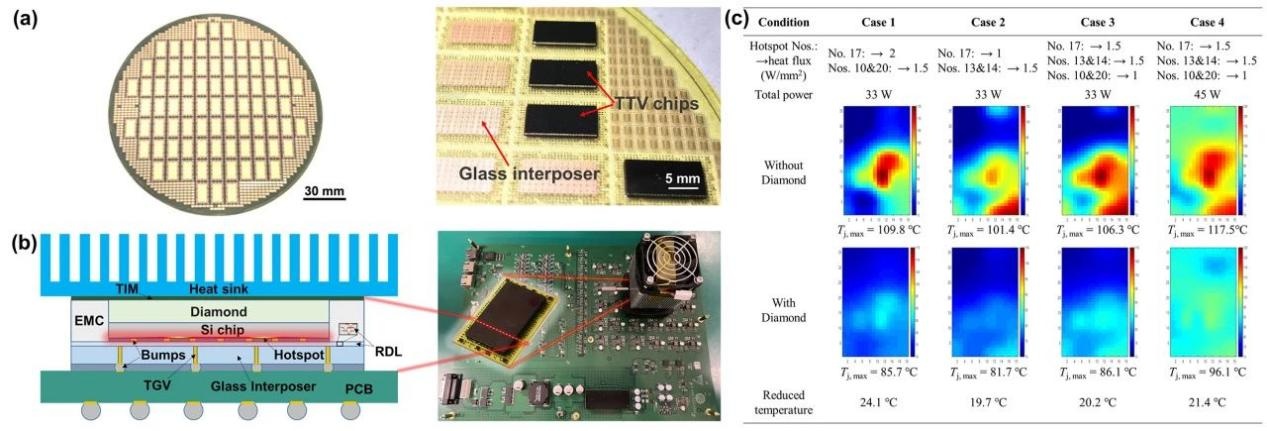
多晶金剛石襯底集成到玻璃轉接板封裝芯片背面及其散熱性能表征
這項研究將金剛石低溫鍵合與玻璃轉接板技術相結合,,首次實現(xiàn)了將多晶金剛石襯底集成到玻璃轉接板封裝芯片的背面。該技術路線符合電子設備尺寸小型化,、重量輕量化的發(fā)展趨勢,,同時與現(xiàn)有散熱方案有效兼容,成為當前實現(xiàn)芯片高效散熱的重要突破路徑,,并推動了金剛石散熱襯底在先進封裝芯片集成的產業(yè)化發(fā)展,。

該成果以“Heterogeneous Integration of Diamond-on-Chip-on-Glass Interposer for Efficient Thermal Management”為題發(fā)表在微電子器件封裝制造領域的國際權威期刊IEEE Electron Device Letters上,并被選為當期封面文章(Front cover)及編輯精選文章(Editors’ Picks),。
資料來源:廈門大學電子科學與技術學院
(中國粉體網編輯整理/山川)
注:圖片非商業(yè)用途,,存在侵權告知刪除























