�Ї����w�W(w��ng)Ӎ ����,���|����W(xu��)�����ɹ��_�l(f��)��һ�(xi��ng)ᘌ���һ���댧(d��o)�w��������ġ������ӹ����g(sh��)�������ڲ��������ό�(sh��)�F(xi��n)�߾���,���OС���c�߿v�M�ȵ��ӹ�,����(sh��)�(y��n)�в��õIJ��������AGC��˾���a(ch��n)�ġ�EN-A1����
�¹�̼��g(sh��)�аl(f��)������оƬС�ͻ��ĬF(xi��n)��(sh��)����
�S����̼��g(sh��)�ĵ�������,���댧(d��o)�wоƬ�������ߴ���m(x��)�sС,���c��ͬ�r�����d�댧(d��o)�wоƬ���·���ڲ����O(sh��)Ӌ��,�������R����·����(x��)������������,��Ҳ��Ҫ�M�����e���ɵİl(f��)չڅ�ݡ�����,������5G,��6Gͨ���I(l��ng)�����l�ʵ���̖��ݔ������ǰ�ؼ��g(sh��)�����е���Ҫ��Ҳ�c�վ���,��
���y(t��ng)�·���ձ���Ø�֬����������,���������m���������g(sh��)Ҫ����������Ę�֬�����D(zhu��n)��,���������Ͼ߂��@����(y��u)�ݣ�һ����,������l��̖�p�ĵͣ��ܸ��õ؝M�����ͨ�ŵ���������,����һ����,�����������ڴ���e������(n��i)�ܱ��փ�(y��u)����ƽ���ȣ��ҟ���Ûϵ��(sh��)�c��߶�ƥ��,������Ч���������Ŀɿ���,��
���·��ĽY(ji��)��(g��u)�O(sh��)Ӌ�У�ǰ��Ӳ�����Ҫ����ͨ��(sh��)�F(xi��n)늚��B��,�������ܶȲ����t���ӹ�����ˇ�(y��n)��Ҫ��,��Ȼ��,������������͵Ĵ��Բ��ϣ��ڼӹ�ֱ���OС����וr���R�@������(zh��n)�����@���^����������(y��ng)�����Ќ�(d��o)���_��,���y�Ԍ�(sh��)�F(xi��n)ֱ���Ⱥ;��ȼ�ߵļӹ�Ч��,��
Ŀǰ�������@���g(sh��)��Ҫ�֞黯�W(xu��)�g�̺ͼ����@�׃��,�����@�ɷN��ˇ�����ھ�����,����δ�l(f��)չ���������a(ch��n)���g(sh��)�����,��ȫ����(n��i)������ᘌ���������(x��)�@���c�߿v�M���@���g(sh��)���аl(f��)�ᳱ,��ּ��ͻ�ƬF(xi��n)�м��g(sh��)ƿ�i���ƄӲ������������M(j��n)��ӷ��b�I(l��ng)���Ҏ(gu��)�,�����(y��ng)��,��
�������EN-A1���������i�댧(d��o)�w�ӹ���ƪ
�|����W(xu��)�аl(f��)�F(tu��n)꠲��Æ�һ����ӹ���ˇ,���ɹ���EN-A1������������ӹ�,������댧(d��o)�w�r�ײ��ϣ�EN-A1������߃�(y��u)����늚������c������,��
���������}�_�����⼤����,���F(tu��n)ꠌ�(sh��)�F(xi��n)�ˌ��������ϵ������ܼӹ���������ֱ��С��10�ף��v�M�ȿ��_(d��)20:1,����ǰ,������������Һ���g�̹�ˇ�y���Ƃ�߿v�M�ȿY(ji��)��(g��u)���������⼤��ֱ�Ӽӹ����g(sh��)���Hͻ�����@һƿ�i,������(sh��)�F(xi��n)�˟o�Ѽy�ĸ��|(zh��)�����ͼӹ�,�����⣬ԓ��ˇ�o�軯�W(xu��)̎�����E,�����@���p��Һ�w�U����̎�펧���ĭh(hu��n)��ؓ(f��)��(d��n),��
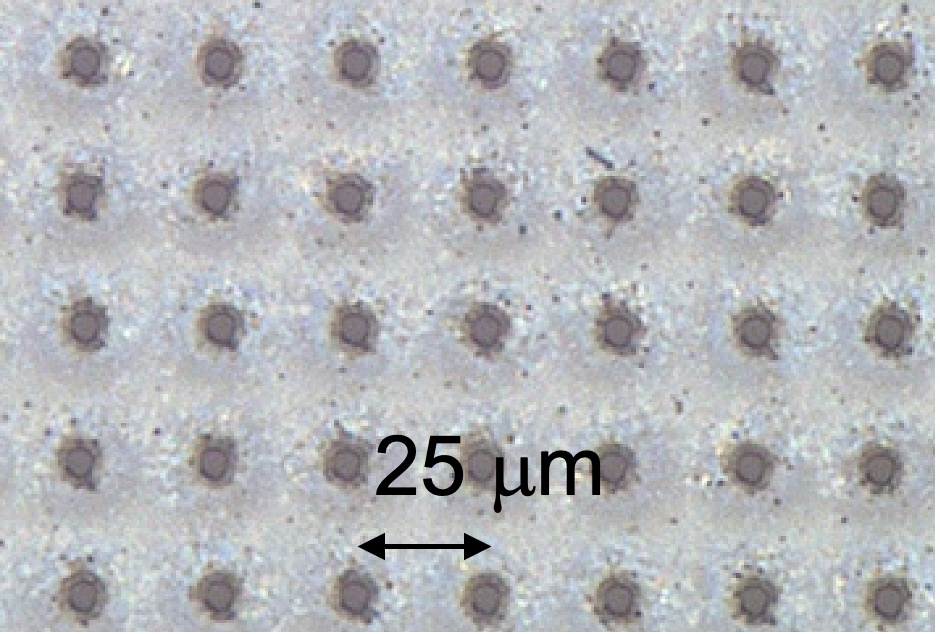

�Ϸ��͂�(c��)���^��EN-A1�������@�����@�D�� ��Դ��Toshio Otsu.High-aspect-ratio, 6-��m-diameter through-glass-via fabrication into 100-��m thick EN-A1 by dry laser micro-drilling process
�@һ�ɹ�����һ���댧(d��o)�w�����̎�����g(sh��)����Ҫ��̱����S���r��о���c�н�Ӳ����������^��,��ԓ���g(sh��)�鲣�������ͨ�ӹ��ṩ���P(gu��n)�I��Q����,��δ������������СоƬ��Chiplet�����g(sh��)���ƄӰ댧(d��o)�w�������С�ͻ�,�������ɏ�(f��)�s�ȵķ���l(f��)չ,��
������Դ:
�|����W(xu��)�������
Toshio Otsu.High-aspect-ratio, 6-��m-diameter through-glass-via fabrication into 100-��m thick EN-A1 by dry laser micro-drilling process
(�Ї����w�W(w��ng)������/����)
ע:�DƬ���̘I(y��)��;�������֙�(qu��n)��֪�h��!


















