�Ї����w�W(w��ng)Ӎ ����,����������ڻ���ƽ�_��ʾ,����˾IGBT�մɻ�������µ�AMB��ˇ���g(sh��),������DBC��AMB���ߌ�����,���͟���,���͛_������˾���܇�S�M�Ї��a(ch��n)�����,��ԓ�մɻ���Ҳ����������Դ��܇��IGBTģ�K��,��
ɢ��Ϳɿ�����IGBT��횽�Q���P(gu��n)�I���}
�^�����p�O���w�ܣ�IGBT�����ڽ����������Ч�����w�ܣ�MOSFET�����p�O���w�ܵĻ��A�ϰl(f��)չ������һ�N���͏ͺϹ�������������ݔ���迹��,���(q��)�ӹ���С,���_�P(gu��n)�ٶȿ졢�����l�ʸߡ�͉�����,����ȫ�����^(q��)��Ϳ���늉��ʹ������һϵ�Ѓ�(y��u)�c,����Ҏ(gu��)ģ������늄���܇������C܇���늙C�(q��)���Լ����W(w��ng)���g(sh��),�������վ,�����I(y��)�I(l��ng)��ĸ߉���������ϵĽ�ֱ����D(zhu��n)�Q��׃�l���Ƶ��I(l��ng)�����������I(l��ng)��������Ҫ�Ĵ�������,���ǾGɫ��(j��ng)���ĺˡ�о��,��
������IGBT���g(sh��)�T���^�ߣ�����(n��i)оƬ�ͷ��b���g(sh��)һֱ�]�Ы@�úܺõ�ͻ��,��������(n��i)IGBT�Ј�һֱ���W���յ���I(y��)���Ŕ�,��������H��IGBTģ�K���g(sh��)�ѽ�(j��ng)�l(f��)չ���˵����������оƬ���g(sh��)��,�����b���g(sh��)Ҳ�dz��P(gu��n)�I,���µķ��b���Ϻ��µķ��b���g(sh��)�ӳ����F������܉����ͨ,��늄���܇�õĸ߉�,����������߹���IGBTģ�K���f,��ɢ��Ϳɿ��������횽�Q���P(gu��n)�I���},��
DBC�մɻ���
ֱ���I���~(DBC)�մɻ�������1000�����ϵĸߜؗl���£��ں����ĵ����мӟ�,��ʹ�~�����մɻ���ͨ�^�����I�ϵķ�ʽ�ι̽Y(ji��)����һ��,�����I�Ϗ��ȸ��Ҿ������õČ����Ժ᷀͟(w��n)���ԡ�

2018��,������ϼ�������A�����ضȞ�600��,���r�g1h�����։���5��10-4MPa�ėl����,�����~������@���������Ҿ����Cu2O��Ĥ,��ԓ��Ĥ�c���w�~�o�ܽY(ji��)�ϣ���Ч�����DBC����ĽY(ji��)������,��
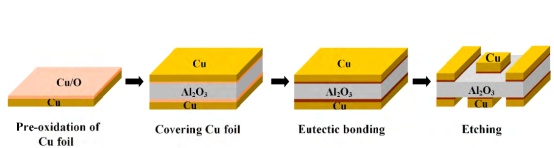
DBC�մɻ����Ƃ乤ˇ����
DBC���Ќ����Ժ�,���^���ԏ����ɿ��Ըߵȃ�(y��u)�c,���яV��������IGBT,��LD��CPV���b��DBCȱ�c����,���������˸ߜ���Cu�cAl2O3�g�Ĺ�������,�����O���ˇ����Ҫ���^��,������ɱ��^�ߣ�����Al2O3�cCu���g���a(ch��n)�����,�������ˮa(ch��n)Ʒ����_����,�������~���ڸߜ��������N��׃�Σ����DBC�����~�����һ�����100m,��ͬ�r���ڲ��û��W���g��ˇ,��DBC����D�ε���С����һ�����100m��
AMB�մɻ���
���Խ��ٺ���(AMB)�մɻ������ú���������Ԫ�صĻ��Խ��ٺ��ό��F(xi��n)�~���c�մɻ�Ƭ�g�ĺ���,�����Ժ���ͨ�^����ͨ���ٺ���������Ti,��Zr,��Hf��V,��Nb��Ta��ϡ��Ԫ���Ƃ�,������ϡ��Ԫ�ؾ��и��ԣ�����ߺ����ۻ����մɵĝ�����,��ʹ�մɱ���o����ٻ��Ϳ��c���ٌ��F(xi��n)����,��
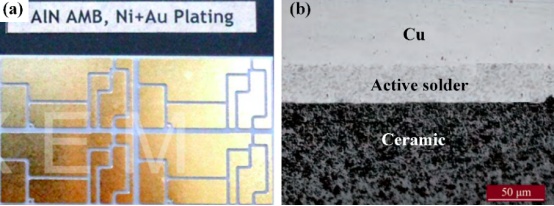
AMB�մɻ���a(ch��n)Ʒ����(b)����D
AMB�����Ƃ似�g(sh��)��DBC���幤ˇ�ĸ��M(DBC�����Ƃ����~���c�մ��ڸߜ���ֱ���I�ϣ���AMB������û��Ժ��ό��F(xi��n)�~���c�մɻ�Ƭ�g�I��),��ͨ�^�x�û��Ժ��Ͽɽ����I�Ϝض�(����800��C),���M�������մɻ����(n��i)���ᑪ����
����,��AMB�����������Ժ����c�մɰl(f��)�����W�������F(xi��n)�I��,����˽Y(ji��)�Ϗ��ȸߣ��ɿ��Ժ�,������ԓ�����ɱ��^��,�����m�Ļ��Ժ����^�٣��Һ��ϳɷ��c��ˇ�������|(zh��)��Ӱ��^��,��Ŀǰֻ���ٔ�(sh��)������I(y��)������AMB�������a(ch��n)���g(sh��),��
�漰�����մɲ���
Ŀǰ���������մɸ��~�������Ϲ������N�մ�,���քe�������X�մɻ���,�������X�մɻ���͵������մɻ��塣�����X���մɻ�������õ��մɻ���,�����������кõĽ^����,���õĻ��W��(w��n)���ԡ��õ����W���ܺ͵͵ăr��,�������������X�մɻ�Ƭ�͵ğጧ��,���c��ğ���Ûϵ��(sh��)ƥ�䲻��,������߹���ģ�K���b���ϣ������X���ϵđ���ǰ�����ݘ��^,��
�����X������иߵğጧ�ʺ��c��,��̼���������ƥ��ğ���Ûϵ��(sh��)�����^��������մɻ������,��Ŀǰ,�������X�մɻ����ѽ�(j��ng)�ɞ�߶˹���ģ�K�����x�մɻ�����ϡ�Ȼ��,���oՓ�������X߀�ǵ����X�մɻ���,���俹�����Ⱥ͔����g�Զ������^�ͣ����º��ӟo���~���ڟ�ѭ�h(hu��n)�^���������_��,��Ӱ���������ģ�K�Ŀɿ���,��
�մɸ��~�������������
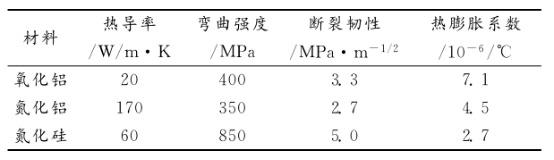
�������մɾ���2.4���������X�͵����X�Ŀ������ȣ���˾��бȵ����X�ߵö�Ŀɿ���,�������Ǹߏ��ȿ��Ԍ��F(xi��n)���c���~����ĸ���,����������ğ����ܡ�
ͬ�r,����-Si3N4�մɾ��Н��ڵ��^�ߟጧ�ʣ�200��320W/����K��,���������^�Y(ji��)��(g��u)������s�����ӵ�ɢ���^��,���ʟጧ���^��,�������������鹦��ģ�K������ϵđ��á����,��Ŀǰ������о��P(gu��n)ע�������ߵ������մɵğጧ��,��
�Y(ji��)
����DBC�մɻ����Ƃ乤ˇ�ضȸߣ������c�մɽ��摪����,�����AMB���g(sh��)Խ��Խ�ܵ��I(y��)���P(gu��n)ע,���e�Dz��õ͜ػ��Ժ��ϡ�������ӱ�ʾ,��Ŀǰ����(n��i)��IGBTģ�K��߀�Dz���DBC��ˇ,���S������늉�������Ҫ��IJ�������,��AMB��ˇ���g(sh��)���մɻ����ܸ��õؽ�Q����ʹ�c,��Ŀǰԓ���g(sh��)���H����܇�I(l��ng)��߀�ں���,��܉����ͨ,�����I(y��)늾W(w��ng)�I(l��ng)��V�����á�
����,���Ƃ���Ժ�����AMB�����Ƃ��P(gu��n)�I���g(sh��),������������е��F���Ͼ߂���߿ɿ�������,�����_��1000�����_���yԇ���M�㺽�պ��������Ҫ��,�������DBC��ˇ���մ��r��,���߂���ߵČ����ԡ��ɿ���,���a(ch��n)Ʒ�ɏV��������IGBT���ʰ댧�w,��
������Դ��
[1]�̺Ƶ�.��ӷ��b�մɻ���
[2]�����.�մɻ����о��F(xi��n)����Mչ
[3]�w�|����.����ģ�K���մɸ��~�����о��Mչ




















