中國粉體網(wǎng)訊 半導體封裝材料是一種覆蓋和保護半導體芯片的材料,它在維護器件完整性,、提供電氣連接以及在極端工作條件下保護芯片免受環(huán)境影響方面發(fā)揮著關鍵作用。在半導體封裝材料方面,,主要材料為封裝基板,,占比為33%。
當前,,隨著半導體技術的發(fā)展,,半導體器件沿著大功率化、高頻化,、集成化的方向迅猛發(fā)展,,器件在工作中產(chǎn)生的熱量是引起半導體器件失效的關鍵因素,。因此,封裝基板的主要性能圍繞可靠性和散熱性,,就需要考慮熱力學性能,,要有高熱導率和適當?shù)臒崤蛎浵禂?shù)。在多種半導體封裝材料中,,陶瓷封裝材料因其耐高溫,、良好的化學穩(wěn)定性和電絕緣性而備受青睞。
陶瓷是硬脆性材料,,陶瓷封裝屬于氣密性封裝,,是高可靠度需求的主要封裝技術,目前已經(jīng)投入生產(chǎn)應用的陶瓷基片主要包括氧化鈹(BeO),、氧化鋁(Al2O3)和氮化鋁(AlN),、氮化硅(Si3N4)等等。
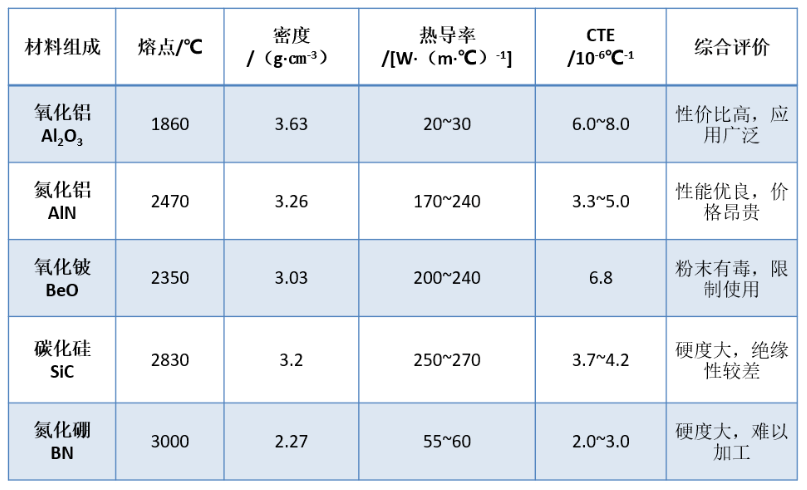
Al2O3是目前制作和加工技術最成熟的陶瓷基片材料,,雖然其應用最成熟,,但是因其熱導率較低結(jié)和熱膨脹系數(shù)較高兩個特點,決定了Al2O3基板并不適合半導體器件大功率的發(fā)展趨勢,;AlN具有優(yōu)秀的導熱性能和與半導體材料相匹配的線膨脹系數(shù),,但其力學性能差且成本較高;Si3N4被認為是綜合性能最好的陶瓷基板材料,,雖熱導率不如氮化鋁,,但其抗彎強度、斷裂韌性都可達到氮化鋁的2倍以上,。同時,,氮化硅陶瓷基板的熱膨脹系數(shù)與第三代半導體碳化硅相近,使得其成為碳化硅導熱基板材料的首選,。
綜合來看,,AlN陶瓷基板與Si3N4陶瓷基板最具發(fā)展前景。
中國粉體網(wǎng)將于2024年4月25日在江蘇蘇州舉辦“第三屆半導體行業(yè)用陶瓷材料技術研討會暨第三代半導體SiC晶體生長技術交流會”,,屆時,,湖南大學肖漢寧教授帶來題為《半導體封裝用陶瓷材料研究進展》的報告。歡迎報名參會~

來源:
師阿維等:高熱導率材料的發(fā)展和應用
千際投行:2023年半導體材料行業(yè)研究報告
中國粉體網(wǎng)
(中國粉體網(wǎng)編輯整理/空青)
注:圖片非商業(yè)用途,,存在侵權告知刪除





















